用于先进半导体封装的热处理设备
随着IoT、5G 和人工智能的普及,对高性能半导体的需求正在迅速增长。 通过微型化实现的高集成度在技术和成本方面已接近极限, 2.5D 和 3D 等先进半导体封装技术备受关注。 我们提供一系列用于先进半导体封装的热处理设备,为下一代半导体的制造做出贡献。
什么是先进半导体封装?
先进半导体封装是将多个具有不同功能的半导体芯片封装在一个封装内,是指将多个芯片(chiplets)安装在一个高密度封装中的半导体产品。
这些产品被称为 2.5D-IC 或 3D-IC 。芯片之间的距离比每个芯片单独封装时要短。从而提高了信息传输速度。此外,将具有不同功能的芯片组合在一起比制作一个具有多种功能的大型芯片更好。不仅降低了成本、也提高了产能及生产率。
以往传统半导体制造过程是分工合作的,代工厂负责前端工序,OSAT 负责后端工序。 然而,在先进半导体封装制造中,前端和后端技术均可利用,因此这两个领域的企业数量都在不断增加。
具有高性能的先进半导体封装技术被广泛应用于AI、高性能通信、5G通信、智能手机、IoT设备、无人驾驶等各种领域和产品。

先进半导体封装的热处理工艺
除了印刷基板(PCB)的干燥、Si中间膜-RDL(重新配线层)和玻璃中间膜等各种类型的热处理外,该系统还支持焊接凸点形成后的回流焊接和芯片成型后的烧成,我们在为FO-WLP(Fan-out晶圆级封装)和WL-CSP(晶圆级芯片尺寸封装)提供热处理设备方面也拥有丰富的经验。
我们利用在半导体制造设备和液晶基板设备制造方面积累的经验和技术,为先进半导体封装的各种制造工艺提供设备。
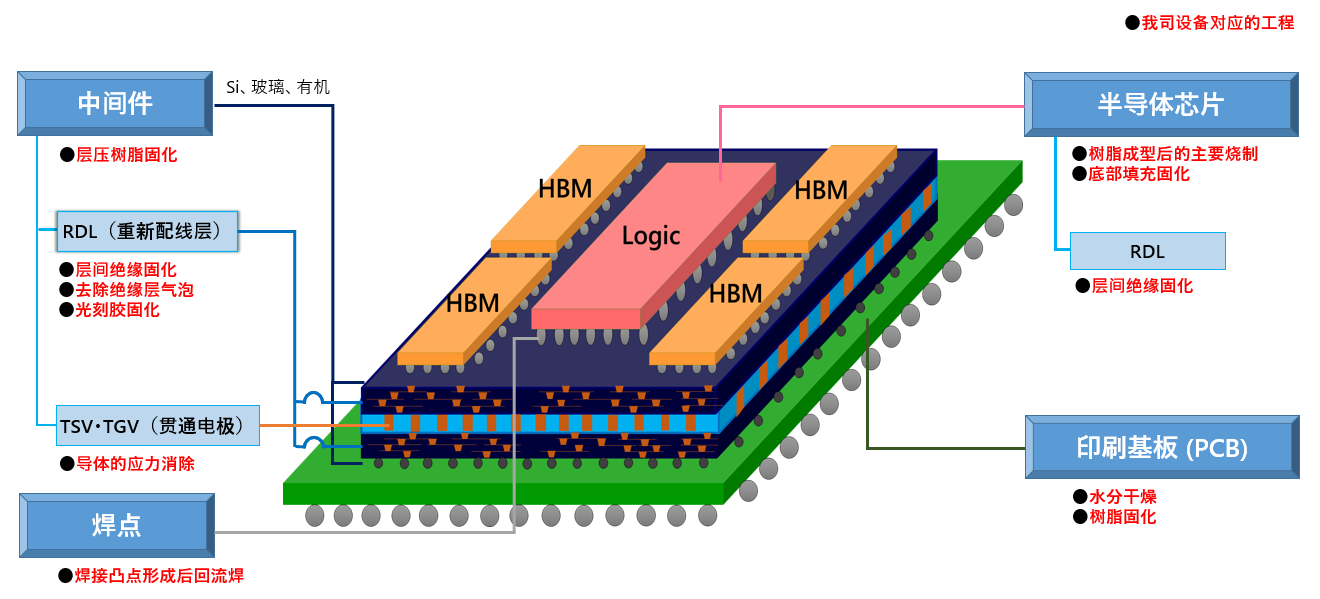
产品系列
| 设备型号 | 量产用 | 研发用 | ||||
|---|---|---|---|---|---|---|
| 洁净烘箱 | 立式炉 | 大口径立式炉 | 洁净烘箱 | |||
| SO2-12-F SO2-12L-F |
SO2-30L-F | SO2-60-F | VF-5700B-F2 VF-5900B |
VFS-4000 | CLH-21CD(H) CLH-35CD(H) |
|
| FO-WLP | 〇 | ― | ― | 〇 | ― | 〇 |
| FO-PLP | ― | 〇 | 〇 | ― | 〇 | 〇 |
| Si 中间膜 | 〇 | 〇 | ― | 〇 | ― | 〇 |
| 玻璃 中间膜 |
〇 | 〇 | 〇 | 〇 | 〇 | 〇 |
| 有机 中间膜 |
〇 | 〇 | 〇 | 〇 | 〇 | 〇 |
| 可对应 基板尺寸 |
Φ300 mm | 310×310 mm (300×300 mm) |
510×515 mm 600×600 mm |
Φ300 mm | 310×310 mm (300×300 mm) 510×515 mm 600×600 mm |
Φ300 mm 310×310 mm (300×300 mm) |
| 腔体数量 | 2 | 2 | 2 | 1 | 1 | 1 |
| 最大可处理片数*1/腔体 | 50 枚*2, 52 枚*3 |
26 枚 | 24 枚 | 75 枚*4, 100 枚*5 |
12 枚 | ― |
| 加热方式 | 热风循环式 | 电阻加热式 | 热风循环式 | |||
| 基板传送 | 机器人传送 | 手动 | ||||
| I/O数 (FOUP) | 4 | 4 | 4 | 2 | 2 | ― |
| 使用温度范围 | 70~450℃*2, 70~400℃*3 |
70~400℃ | 70~350℃ 70~400℃ (可选) |
~750℃ | ~600℃ | RT+70~530℃ |
| 残留 氧浓度 |
10ppm以下 | 20ppm以下 | ||||
| 自清洁 | ― | ― | ― | 高温burnout | ― | |
*1 处理片数受基板厚度、翘曲变化。
*2 SO2-12-F
*3 SO2-12L-F
*4 VF-5700B-F2
*5 VF-5900B





